中國科學院在氮化鎵低壓射頻器件領域取得新進展
近年來,5G通信應用向手機等移動終端場景深度拓展,對低壓高性能射頻功率放大器(PA)的需求日益迫切。氮化鎵(GaN)高電子遷移率晶體管(HEMT)因其高電子飽和速率和優異的二維電子氣(2DEG)輸運特性,已成為實現高性能射頻前端的理想選擇。然而,常規GaN器件存在較高的膝點電壓,嚴重制約了其在低壓條件下的射頻輸出性能。針對這一問題,國際上的常規做法是采用強極化異質結(如InAlN/GaN、AlN/GaN等)以及“深度縮放”工藝路線,對加工精度要求較高。
近日,蘇州納米所孫錢研究員團隊成功研制出一種基于AlGaN/GaN異質結的硅基氮化鎵“近無接入區”金屬-絕緣體-半導體高電子遷移率晶體管(MIS-HEMT)器件,基于結構創新,在較為寬松的加工精度條件下,有效降低了膝點電壓,并在低壓應用中展現出卓越的直流與射頻性能。
研究團隊通過將源漏極歐姆接觸區域延伸至柵極邊緣,并采用n??-GaN二次外延技術,有效抑制了常規器件中由非柵控2DEG區域引入的接入區電阻,進而顯著提升了器件的輸出特性。該器件在550 nm柵長下,實現了2.11 A/mm的飽和電流密度、300 mS/mm的峰值跨導以及0.61 Ω·mm的低導通電阻,歐姆接觸電阻低至0.09 Ω·mm。
在3.5 GHz頻段的負載牽引測試中,器件在5 V漏極電壓下輸出功率密度達0.81 W/mm,線性增益10.5 dB,峰值功率附加效率(PAE)為19.4%。尤為值得關注的是,在射頻功率應用場景下,通過線性外推法提取得到器件的膝點電壓僅0.75 V,是目前已公開報道的低壓GaN射頻器件中的最優值。下一步將通過選區生長高阻GaN、抬升T柵等方面的研究,進一步提升器件性能。
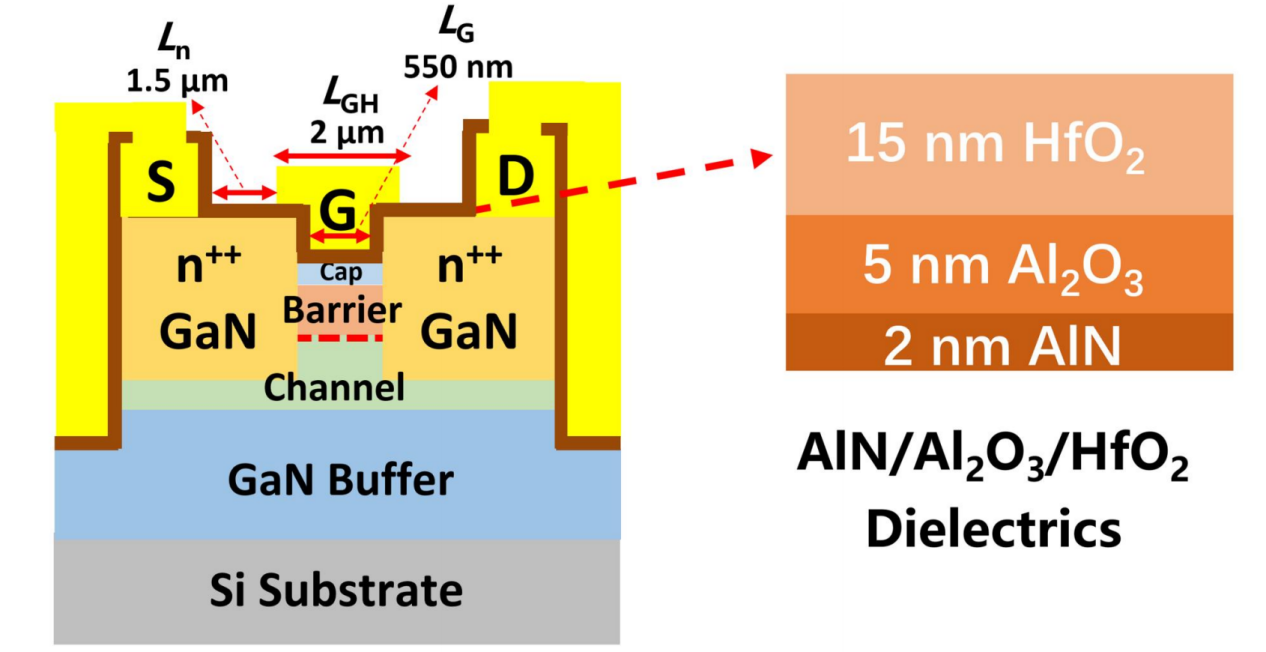
圖1 硅基氮化鎵近無接入區MIS-HEMT器件結構截面示意圖

圖2 硅基氮化鎵近無接入區MIS-HEMT器件結構的(a)轉移特性(b)輸出特性(c)三端口漏電特性(d)三端口關態擊穿特性
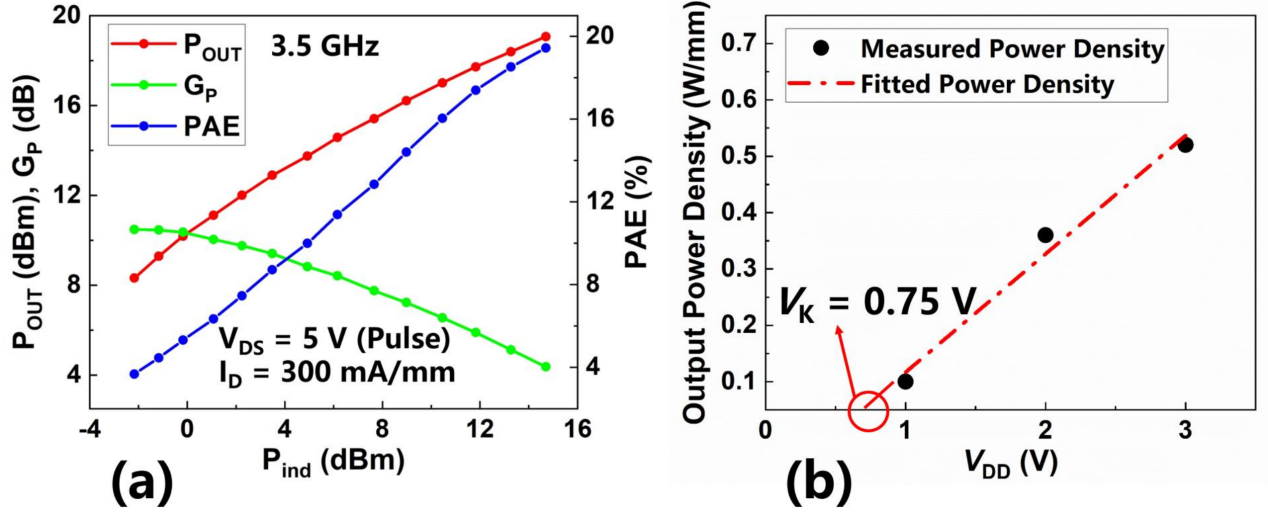
圖3 硅基氮化鎵近無接入區MIS-HEMT器件結構(a)3.5 GHz下基于負載牽引測試的射頻功率特性(b)膝點電壓外推結果
該研究成果以AlGaN/GaN MIS-HEMT Nominally Free of Access Regions on Si for Low-Voltage RF Applications為題發表于國際微波射頻領域權威期刊IEEE Microwave and Wireless Technology Letters。論文第一作者為張新堃博士,現為團隊在站博士后。
本研究與團隊前期在國際微電子領域期刊Semiconductor Science and Technology上發表的另一項研究工作(Impact of eliminating ungated access regions on DC and thermal performance of GaN-based MIS-HEMT)關系密切。在前期研究中,團隊系統地揭示了接入區對GaN器件電學與熱學性能的影響機制,指出:抑制接入區有望顯著提升器件的低壓輸出特性。以此為基礎,本研究進一步提出并驗證了一種區別于常規“深度縮放”的低壓射頻器件工藝路線,通過有效抑制接入區電阻,實現了膝點電壓的有效控制乃至器件整體射頻輸出特性的提升,為低壓Sub-6GHz射頻前端芯片的發展提供了新思路。
相關工作得到了國家重點研發計劃、國家科技重大專項、國家自然科學基金、中國科學院戰略性先導科技專項、江蘇省重點研發計劃、蘇州市科技計劃等多個項目的支持。相關器件制備與測試在蘇州納米所納米加工平臺、納米測試分析平臺以及納米真空互聯實驗站(Nano-X)完成。







